POP 组装工艺及可靠性研究
背景:
自从Amkor推出POP封装技术至今,业界关于POP技术的研究热情从来没有停止过,Amkor公司本身对于POP的组装及可靠性进行了相当多的研究,业界的OEM厂也就POP的应用等进行了大量的研究,目前POP在很多的PDA等终端产品中都有应用。
目前业界的贴片机大都进行了POP组装方面的研究,基本都支持POP的组装,比如SIMENS,Universial,Assemblon,Panasonic等。
JSTD95标准第22章节(Fine-pitch, Square Ball Grid Array Package (FBGA) Package-on-Package (PoP) ,2007 年9月,B版本)定义POP尺寸最大为21 mm×21 mm,引脚间距0.4 mm、0.5 mm、0.65 mm和0.8 mm;
JC63组织关于POP顶层存储器引脚输出标准化的制定中显示的最大尺寸为16 mm×16 mm(07年11月版本),引脚间距为0.5、0.65;
1 实验设计
1.1 器件信息
项目研究用的POP器件信息见表1。
1.2 PCB设计及器件布局
PCB设计及器件布局如图2所示。
1.3 组装用材料
组装材料包括锡膏、POP top层用助焊剂、POP top层用锡膏、Underfill。顶层助焊剂材料选择F1,顶层焊接锡膏材料选用S1和S2两种,underfill材料选择U1和U2。PoP top层用焊接材料信息见表2。Underfill材料性能参数见表3。

2 组装试验过程及结果分析
2.1 器件高温变形测试
采用DIC(Digital image correlation)方法进行器件的高温变形测试。
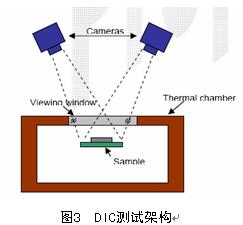
对于器件高温变形,选取测试温度为:25 – 40 – 55 – 70 – 85 – 100 – 115 – 130 – 145 – 160 – 175 – 190 – 205 – 220 – 240 (°C),测试结果主要考虑下面对角方向,测量位置主要考虑POP底部器件顶层,POP顶部器件底层以及两个器件堆叠后的底层,测试时所有焊球都被移除。
对于POP底部器件相对变形(以室温测量结果为参考平面)测试结果的3D图像如下所示:


结果显示,POP底部单个器件高温变形在0.1 mm,顶部器件高温变形在0.03mm,而两个器件焊接在一起后的高温变形在0.07 mm。器件变形都是笑脸。
2.2 顶层器件助焊剂浸渍
POP顶部器件的焊球高度的标称值为0.3 mm,其中min=0.27 mm。max=0.33 mm,其30%和50%深度的尺寸分别为:0.09 mm和0.15 mm,考虑到厚薄尺的规格,将浸蘸深度调整为3.5 mil~4 mil和6 mil。
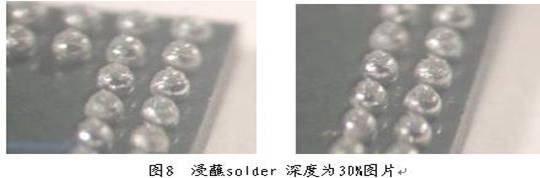
从图片上可以看出,用来POP加工的flux的粘度较正常使用的flux粘度要低,当把器件倒立时,flux由于重力作用有向下流动的情况;浸蘸30%厚度的sloder的情况下,蘸取的锡膏量较少,并且由于器件焊球高度本身存在差异,导致不同的焊球蘸取锡膏的量也有不同。
2.3 5DX检测
对单板进行5DX检测,均没有发现连锡情况,并且5DX通过调整聚焦位置,可以清晰看到不同层的焊球情况,如下图:
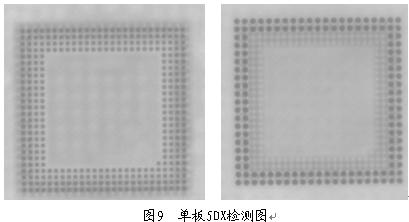
2.4 组装试验结果
组装试验阶段全部采用B的POP器件,器件的测试结果见表4。
从上面的组装测试结果来看, flux的组装质量是最稳定的,截至目前还没有出现过任何不良。
对浸蘸不同flux和solder的加工单板的器件,进行切片观察,并进行了相关的焊点尺寸的测量,由于底部器件焊接所用材料及温度曲线均相同,因此不同实验参数之间切片分析无显著差异,所有器件切片均有一个明显特征,显示出边角处standoff较高而中心焊点standoff较低的特征,如下图所示。