在笔记本和平板电脑行业中,金属的成分越来越多的应用,组装中出现光用结构和卡扣来实现电子产品的超薄超轻的特点是很难了,结构上的设计越来越多的使用胶粘剂(如14167-NC)来实现无间隙和扁平薄的外观.
DEVCON 14167-NC 快固型复合材料冷焊剂是美国ITW集团OEM胶粘剂的一种。属于多用途的甲基丙烯酸结构胶,适用于笔记本、平板电脑壳体的结构粘合,固化迅速,紧固时间短,有超强的耐冲击和抗疲劳性能。
惠普有多个机种使用到这款产品,比如最开始的MINI 2133。全铝合金的外壳和超轻的重量打破了对塑料外壳沉重呆板的印象。
|
Devcon 14167-NC |
|
|
双组份配比 |
10:1 |
|
混合后粘度 |
110000mPa.S |
|
操作时间 |
3-5min(23℃) |
|
夹固时间 |
8min(23℃)或1min(50-60℃) |
|
完全固化时间 |
24H(23℃) |
|
耐温范围 |
零下40℃-121℃ |
|
剪切强度 |
19.6MPa(ASTM D1002) |
|
断裂延伸率 |
100%-125% |
|
耐冲击强度 |
2J/mm2 |
|
耐剥离能力强 |
42pli(ASTM D1876) |

笔记本外壳粘合
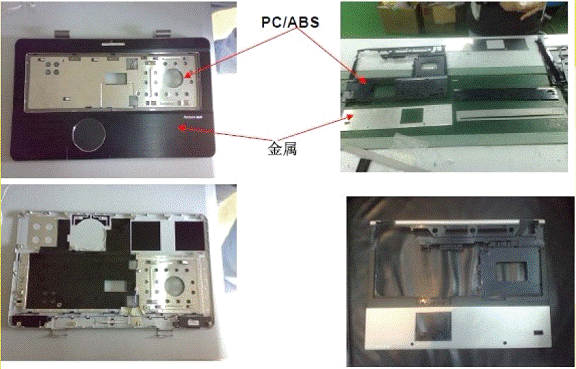
点胶工艺参数


芯片保护
� 应用案例: 摩托罗拉
� 应用点:BGA、CSP和FLIP CHIP
� 胶粘剂:underfill (底部填充胶),corner bonding(四角邦定);
underfill (底部填充胶)应用:
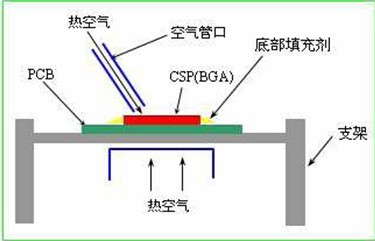
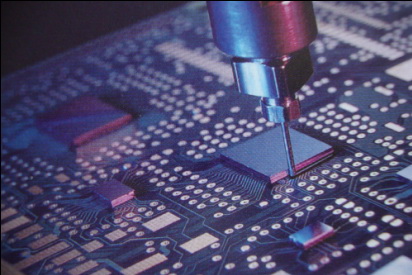
underfill(底部填充胶)用于倒装芯片、CSP和BGA设备的创新型毛细流动底部填充剂。这是一种高流动性、高纯度的单组分灌封材料、它们能够形成均匀且无空洞的底部填充层,通过消除由焊接材料引起的应力,提高元器件的可靠性和机械性能。我们提供的配方可以对极细间距的部件进行快速填充,具有快速固化能力,拥有较长的工作寿命和使用寿命以及可返修性。可返修性允许清除底部填充剂以便对电路板再度加以利用,从而节省了成本。
倒装芯片组装要求再度对焊接焊缝进行应力消除,以便延长热力老化和循环寿命。CSP或BGA组装需要使用底部填充剂,以提高组件在弯曲、振动或坠落试验时的机械完整性。汉高的倒装芯片底部填充剂具有专业填充剂的高负荷,可达到低CTE,同时保持在小间距中快速流动,处理高玻璃转化温度和高模量的能力。我们的CSP底部填充剂很少需要加填,选用适合预期应用的玻璃转化温度和模量。
corner bonding(四角邦定)应用:
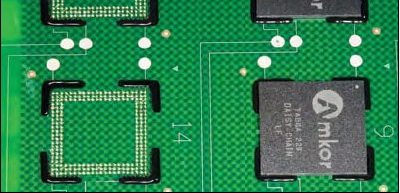
试验工艺流程:如图1所示
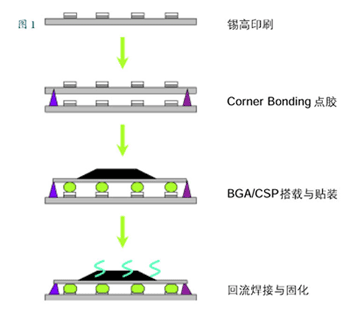
2 确定点胶的分布和模式:如图2和图3示
图2:


图3:

Corner Bonding是一种在线点胶和在线固化的工艺技术,其由于能很好起到提升BGA或CSP等焊接后的机械加固作用,降低机械疲劳和应力失效,保证焊锡品质的可靠性,并能做到生产效率最大化而被广泛应用。
目前在业界通用的胶水固化工艺有:Under fill , Under bonding ,Corner Bonding 等,每个公司在导入胶水固化工艺前,应该根据产品的不同类型、产品可靠性要求、或客户的具体标准去评估和采用合适的胶水固化工艺。
其它的一些应用: