试验经验总结:
国际,国内的一些研究机构对底部填充材料的研究不断提高,并有专利技术产生,三种底部填充材料(材料E与共晶焊料兼容;材料A,B与无铅焊料兼容)被具体研究。单层填充材料可用于有焊球的晶圆上,烘烤后呈透明膜,单层膜现被广泛利用,但因底部填充材料在滴涂和烘烤过程耗时,占用空间大,为节约时间,减少空间占用率,可采用多层滴涂。
表一列出了一系列底部填充材料的研究结果:

表中有两种焊膏来自Indium公司,NC-SMQ92J–为免清洗Sn63/Pb37焊膏,NC-SMQ230—为免清洗95.5Sn/3.8Ag/0.7Cu无铅焊膏(Indium 241)
TMA挤压流动测试:
采用丝网印刷方法,将200微米厚的WLUF材料印刷在玻璃板上的5毫米*5毫米的面积上,WLUF材料上放置TMA探头(TA工具,膨胀计),温度从室温升到150℃@5℃/min爬升温度,压力设置在与节点重量匹配的0.001N上,改变WLUF材料厚度d,并做好相应记录。
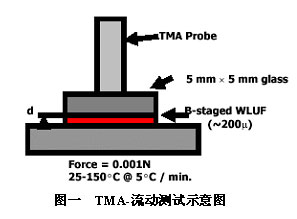
1. DSC应力释放特性:
玻璃板上WLUF材料烘烤后厚度为250微米,然后将其置于预热—退火装置中,退火后,将材料刮下,再在DSC中以10℃/minute的升温速度升温到一定温度,从高温回到室温的退火过程中,压力释放,扫描记录退火过程应力变化情况。
2. 焊料拖尾测试:
底部填充材料固化在玻璃板上,300微米厚的焊膏印刷在OSP处理的裸铜板上,如图二,将有固化填充材料的玻璃板倒放在印刷好的焊膏上,回流,透过玻璃板很容易看到焊料拖尾现象,因焊料直接与底部填充材料接触(无焊球),与正常SMT装配相比,焊料更易引起拖尾。

结论:焊料拖尾与底部填充材料流动:
底部填充材料使用与无铅焊料匹配的材料A,焊膏使用Indium241,图三显示焊膏拖尾实验结果,很显然,焊膏拖尾是由于材料A流动引起的。
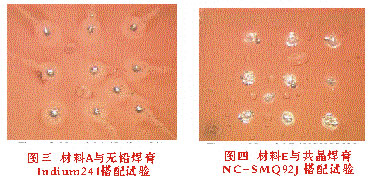
与共晶焊料匹配的材料E与Indium 的Sn63/Pb37焊膏NC-SMQ92J搭配试验,如图四所示,从图中看出,几乎无拖尾现象,且焊料对Cu-OSP润湿性也很好。图五为与共晶焊膏匹配的底部填充材料E与无铅焊膏Indium241搭配结果,图六为与无铅焊膏搭配的底部填充材料A与共晶焊膏NC-SMQ92J搭配结果,图六可看出,焊料对Cu-OSP裸铜板润湿性很差。
通过试验分析,下面两项建议供同行参考:
无铅焊膏内聚力差,对印刷工艺要求简单,Sn/Ag/Cu模量系数大,表面张力大,不易于延伸,通过对217℃的Sn/Ag/Cu与共晶的183℃的Sn63/Pb37焊膏形成的润湿角的分析显示,Sn/Ag/Cu表面张力大,焊料与底部填充材料的关系可以看作液体流过并浸没固体,液体的流动对固体产生浮力(FD)使其拖尾,浮力产生的大小可由下列公式计算:
其中:V:底部填充材料的流动速度
Ap:焊料实际接触底部填充材料的面积
底部填充材料流动速度与其粘性成反比:
因此,浮力FD与底部填充材料的粘性成反比,要想减少拖尾发生,应该减少浮力,即增加底部填充材料的粘性即可。
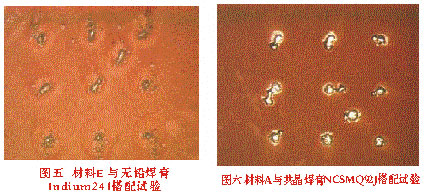
底部填充材料的粘性可通过调整烘烤条件来改变,焊料与底部填充材料匹配结果见图七,增加烘烤时间可降低流动性,从而降低拖尾发生,140℃,烘烤时间为90分钟和120分钟是,拖尾几乎可以完全消除。
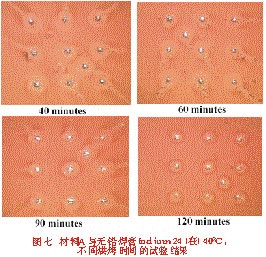
虽然试验证明烘烤时间长可消除拖尾,但对底部填充材料的流动则会产生副作用,如烘烤时间为90分钟和120分钟,装配回流时底部填充材料不能充分流到器件四周边角形成填充保护膜,同时,对焊球与焊盘间形成的焊点起不到保护作用。底部填充材料要求即能控制焊料拖尾,又能形成保护膜保护焊点,粘性高的底部填充材料流动性小,且对焊料有一定凝聚力,而低粘性的底部填充材料流动性好,可以满足后道工艺要求。另外,一种与无铅焊料搭配的材料B,烘烤工艺窗口较大,TMA挤压流动试验可以比较底部填充材料的流动性,材料流动性对探头测出的浮力影响很大,此时,材料厚度补偿很有效。材料A与B在140℃,不同烘烤时间,底部填充材料流动性结果见图八,烘烤时间越长,流动性越差,材料B在烘烤时间60分钟之前流动性很明显好于材料A,所以材料B温度窗口比材料A宽。
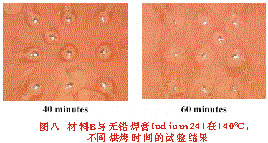
底部填充材料B烘烤时间与焊料装配结果如图九,拖尾情况好于材料A,因此,材料B烘烤时间长并不影响其流动效果。材料A与无铅焊膏Indium241在140℃,不同烘烤时间的试验结果,见图九:
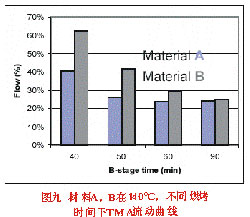
晶圆翘曲与底部填充材料脆裂:
当使用WLUF材料A填充到裸硅晶圆上,会发生严重翘曲(特别是3”和6”晶圆),翘曲原因就是晶圆在填充材料冷却过程中硅材料与填充材料CTE不匹配造成的,通常底部填充材料脆裂释放应力,翘曲变小或消失,为减少应力产生,底部填充材料冷却后要进行退火处理,退火过程中应力的释放可通过DSC观察到,图十即为DSC温度记录图,记录了材料B烘烤后在50℃,不同退火时间的情况。
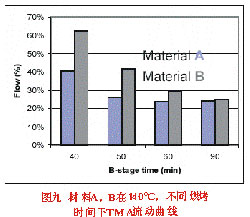
晶片级无铅CSP器件的底部填充材料(二)
退火时间增加,聚合体系统向低应力平衡点移动,吸热头根据Tg变化,可统计出应力释放情况。明确了退火温度对应力释放动力学的影响,退火试验可在不同温度下重复进行,吸热头在不同温度经1H退火后,如图十一,在50℃时应力释放最大,材料B退火温度是55℃,为其玻璃转化温度,因此,应力释放最佳时机为材料玻璃转换温度,DSC温度记录图可对退火和未经退火的材料进行统计分析,退火对材料结构无影响,因此对材料流动,材料结合没有任何影响。当材料B填充到晶圆上,经50℃,30分钟退火,晶圆脆裂可消除,
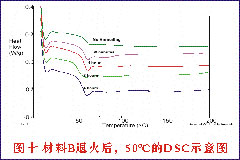

结论:
晶圆底部填充材料,用于无铅焊接的要求更具挑战性,晶片级封装器件在无铅焊接中,焊接温度高,焊料易拖尾,焊接窗口窄,因此,底部填充材料的选择,烘烤工艺的控制非常重要,处理的好,可消除拖尾,并有好的流动性,易于形成良好的保护膜,并协助焊接时良好焊点的形成,可通过调整烘烤时间增加底部填充材料的粘性,改善拖尾情况,底部填充材料可保证其良好的流动性及较宽的工艺窗口。后期烘烤后的退火,可消除晶圆翘曲及脆裂,退火过程中应力释放可通过DSC监控,并可根据材料的玻璃转换外呢度确定有效的退火温度。
参考文献:
1、Ken Gileo,“Flip-Chip Technology:Materials and Processes for NextGeneration of high-Performance Electronics”Electronic Packaging and Interconnection
Handbook ,3ed,McGraw Hill, 2000.
2、D. Suryanarayana,J.A.Varcoe and J.V.Ellerson.“Repairability of Underfill Electronic Components &Technology Conference (ECTC). P524-8.Las Vegas.NA,May.1995.
3、’Materals Challenges for Wafer-level Flip Chip Underfills”Bodan Ma,Eric Zhang,Sun Hee Hong, Quinn K.Tong,and Ann Savoca, 50th ECTC, Las Vegas NV,May 21-24(2000)
4、“Novel Underfill Materials for Wafer-Level Flip-Chip Packaging”,Allison Xiao,Quin Tong ,Gyan Dutt and Ann Savoca,IMAPS Flip-Chip Conference, Austin, TX,June 15-18,2003
5、“Recent advances, of a Wafer Level Flip Chip Packaging Process,”Q.Tong, B Ma, A Savoca,L. Nguyen, C.Quentin,C.P.Wong. And S. Luo, 50th Electron, Comp .&Tech.Conf,(ECTC),Las Vegas, NV, May 21-24(2000)
6、“ Solder Joint Shape Formation under Constrained Boundaries in Wafer Level Underfill,”L .Nguyen and H. Nguyen,submitted for 50th ECTC, Las Vegas, NV, May 21-24(2000).
7、“Lead-free solder Partnership ”Environmental Protection Agercy (EPA) document#EPA 744-F-02-007,
