随着iPhone4S 和 iPad风靡全球,超薄、触屏、智能系统的MID产品成为最新消费新宠。笔记本、平板电脑、手机的设计与制造的过程中,外壳采用合金与工程塑料结合的结构成为新的趋势。生产、组装的过程中光用传统的螺纹和卡扣已很满足实现超薄超轻、立体美观的特点了,为了实现无间隙和扁平薄的外观点,组装制程中越来越多采用胶粘剂来粘接、贴合组件。
智能手机用胶点分析

1、手机屏幕与手机边框粘接
2、手机壳体的粘合
3、侧按键粘接固定
4、摄像头窗口定位
5、LOGO的粘贴
6、芯片、CPU散热
7、芯片保护

|
PUH94167 HV FC |
|
|
颜色(常温/加热) |
白色/半透明 |
|
比重 |
1.19 |
|
粘度@100℃(mPa.S) |
6000 |
|
剪切强度(psi) |
2700(18MPa) |
|
断裂延伸率(%) |
490 |
|
加热温度(℃) |
110 |
|
开放时间(min) |
5 |
|
典型应用 |
塑料+塑料 |
|
塑料+金属 |
|
|
手机零部件粘接(视窗,外壳) |
|
手机屏幕与手机边框粘接
应用案例: 三星P1000
基材: 油墨玻璃与PC/ABS
胶粘剂: Devcon PUH94167

手机壳体的粘合
� 应用案例:摩托罗拉手机
� 基材:塑料与塑料
� 胶粘剂:Devcon PUH9416Devcon PUH94167

侧按键粘接固定
� 应用案例:诺基亚手机
� 基材:TPU与PC/ABS
� 胶粘剂:Devcon CA2400
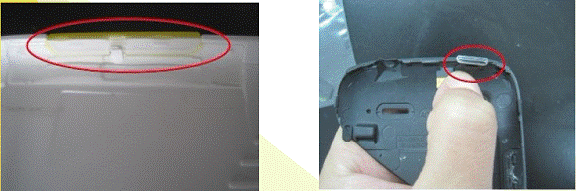
摄像头窗口定位
� 应用案例:诺基亚手机
� 基材:ABS与硅胶
� 胶粘剂:
CA2400+Primer44445

LOGO的粘合
� 应用案例:Lenovo 手机
� 基材:PC/ABS+铝
� 胶粘剂:14167-NC

芯片、CPU散热
� 应用案例: 小米手机
� 应用点:CPU、Flash芯片
� 胶粘剂:石墨薄膜

芯片保护
� 应用案例: 摩托罗拉
� 应用点:BGA、CSP和FLIP CHIP
� 胶粘剂:underfill (底部填充胶)
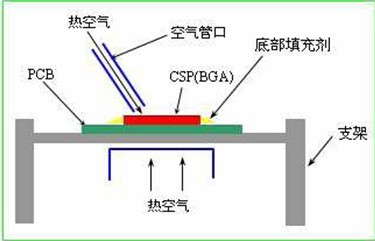
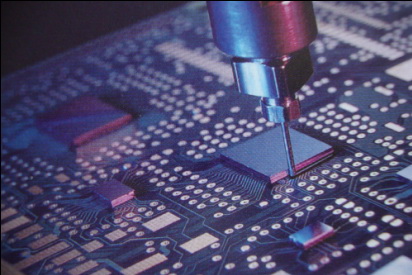
underfill(底部填充胶)用于倒装芯片、CSP和BGA设备的创新型毛细流动底部填充剂。这是一种高流动性、高纯度的单组分灌封材料、它们能够形成均匀且无空洞的底部填充层,通过消除由焊接材料引起的应力,提高元器件的可靠性和机械性能。我们提供的配方可以对极细间距的部件进行快速填充,具有快速固化能力,拥有较长的工作寿命和使用寿命以及可返修性。可返修性允许清除底部填充剂以便对电路板再度加以利用,从而节省了成本。
倒装芯片组装要求再度对焊接焊缝进行应力消除,以便延长热力老化和循环寿命。CSP或BGA组装需要使用底部填充剂,以提高组件在弯曲、振动或坠落试验时的机械完整性。汉高的倒装芯片底部填充剂具有专业填充剂的高负荷,可达到低CTE,同时保持在小间距中快速流动,处理高玻璃转化温度和高模量的能力。我们的CSP底部填充剂很少需要加填,选用适合预期应用的玻璃转化温度和模量。
其它的一些应用: