基于BGA填充胶封装焊点可靠性研究
移动电话、笔记本电脑,上网本,PDA等便携式电子终端产品的小型化、低成本和高性能的要求, 使得BGA芯片需求量越来越高,但客户使用不当,如冲击、震动均可能导致焊点失效,引起产品出现故障,而底部填充胶封装BGA焊点,将芯片与基板黏成一体,减少热循环过程中的相对移动、增加焊点的疲劳寿命、缓冲并释放因冲击在焊点上所产生的应力,但不同的填充胶对基板封装的可靠性却表现不同,本课题通过实验和热应力分析方法,研究筛选出热应力较低的底部填充胶,有效提高BGA封装焊点的可靠性。
1. 实验
1.1实验条件
实验PCB试样是一个2×4阵列BGA的主板,尺寸115x77mm、厚度1.65mm,基材FR-4,焊盘表面处理工艺为HASL。BGA器件为塑封PBGA封装结构、焊球间距0.5mm,芯片尺寸4×4mm。实验选用某品牌BGA填充胶,有A、B、C、D、E等型号。A胶不含填充剂,粘度7250cps(25℃), 热膨胀系数(CTE)60×10-6K-1、固化温度165℃,B胶也不含填充剂,粘度、热膨胀系数与A胶相同,所不同的是固化温度,为135℃。C胶含有60%的二氧化硅填充剂,粘度15000cps(25℃), 热膨胀系数(CTE)31×10-6 K-1、固化温度150℃,D胶含有50%的二氧化硅填充剂,粘度6000cps(25℃), 热膨胀系数(CTE)41×10-6 K-1、固化温度120℃,E胶含有40%的二氧化硅填充剂,粘度5000cps(25℃), 热膨胀系数(CTE)45×10-6 K-1、固化温度115℃。实验选用某品牌免清洗焊膏,再流焊炉支持无铅焊接,实验在室温20~25℃、相对湿度 50~65%RH、气压 101Kpa条件下进行。
1.2实验内容
实验一基板跌落测试。选取实验试样主板15片,分为1、2、3组,每组5片基板,1组不使用填充胶焊接BGA焊点,2组使用A胶焊接BGA焊点,3组使用C胶焊接BGA焊点。实验选用某品牌跌落实验机,主要由冲击台面、基座、导轨、夹具(一般为螺栓)、衬垫(毛毡、尼龙等)组成。装有BGA组件基板通过夹具安装在基座上,其中基座一般是由铝、铁、铜等金属制成的质量较大的块体。当把基座抬升到1830mm高度,然后让其沿导轨自由下落,在基座与放在实验台上的衬垫碰撞的过程中会产生一个冲击载荷,它实际上就是一个冲击加速度脉冲。由于基座及夹具的固有频率比BGA组件的固有频率要大得多,因而可以认为碰撞产生的冲击载荷会无失真地沿着夹具加载到BGA组件上。换句话说,基座连同夹具可以看成一个刚体,这样我们就可以在BGA组件的夹具加持点上直接加载冲击载荷来研究BGA组件的动态特性及焊点的应力应变情况。试样基板跌落每边跌落两次共计8次为一个跌落周期。跌落实验中,当BGA焊点的总串联电阻比跌落前增大20%时,样品被判定为已失效.
实验二基板热循环测试。选取实验试样主板20片,每组5片,分成1、2、3、4组,1组不使用填充胶焊接BGA焊点, 2组使用B胶焊接BGA焊点;3组使用D胶焊接BGA焊点;4组使用E胶焊接BGA焊点。实验参照IPC9701表面安装锡焊件性能实验方法与鉴定要求标准,将焊有BGA的试样基板,放入高低温热冲击箱进行冷热循环实验,高低温热冲击箱有上下两个冷热温度室,通过升降系统使试样循环地蜀于两个温度室中,用控温的干燥空气流对其进行加热和冷却,并与周围环境隔绝,使试样经历所需要的热循环过程。热循环条件采用两种研究方案,方案1要求温度为-40℃~+85℃,循环周期900s,升温速率0.25~0.33℃/s,循环次数1000次;方案2要求温度为 0℃~+100℃,循环周期600s,升温速率0.17℃/s。进行热循环测试的基板从0周开始循环,200周开始观察,以后分别在400、600、800、1000、1100、1200周各取出部分焊点,对其进行金相分析,发现失效BGA焊点。
2、实验结果与分析
实验一,第一组未加底部填充胶BGA试样基板,经过8次跌落的1个周期,测试发现试样基板出现失效现象;第二组填充A胶焊接BGA焊点的试样基板,经过56次跌落的7个周期,测试发现试样基板出现失效现象;第三组填充C胶焊接BGA焊点的试样基板,经过112次跌落14个周期,测试发现试样基板出现失效现象。图1是采用SEM对第3组失效样品BGA焊点截面的微观结构观察分析图,在跌落实验时,样品在碰撞瞬间受到的巨大冲击力使得PCB板发生阻尼震荡,表现为反复的向上/向下弯曲形变. 在这个形变过程中, BGA焊点受到周期性的拉应力作用, 在多次的周期性拉应力作用下,BGA焊接界面将出现疲劳裂痕,并随着裂痕不断扩张、延伸,导致焊接互连体系会出现开裂,最终造成整个BGA /PCB焊接点的疲劳失效,对失效样品的分析表明,BGA焊点的机械疲劳失效通常表现为焊点连接处的裂纹或焊球的开裂,其中大部分裂纹出现在靠近焊点—封装基板Ni/Cu焊盘界面的一侧,图1显示了跌落实验中出现的焊点的不同失效模式,可以看到,焊点受到过应力作用而出现裂纹,裂纹起始于PCB板金属焊盘与BGA焊球焊接界面的边缘,如图1(a)中A处所示,并沿焊接界面向内部延伸,严重的造成整个焊接界面的延性断裂,如图1(b)所示,另外,裂纹也可能穿通PCB的Cu焊盘,并沿焊盘与FR24树脂的界面扩张,使该界面发生分层现象,引起PCB板的开裂,如图1(c)所示。宗上分析,从实验一中可得出,BGA焊点封装填充A胶焊接的试样基板,可大幅度改善耐跌落测试能力。
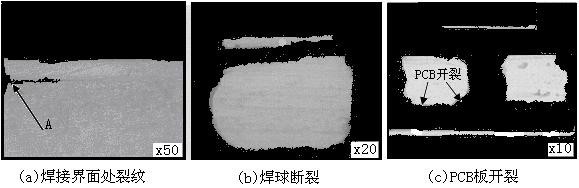
图1 焊点跌落失效SEM图片
实验二,对于方案1,第1组未加底部填充胶BGA试样基板,执行到150个周期,出现第一次焊点失效,且全部样品均未能通过最后的测试,远低于1000周期,平均失效次数低于1000周期。第2、3、4组有填充胶BGA封装的焊点试样基板,在热循环测试中,只有第2组有底部填充胶B的试样基板出现失效,也是唯一出现的焊点失效的试样基板,失效发生在 1000周期以上;对于方案2,第1组未加底部填充胶BGA试样基板,出现第一次失效发生在超过 1000周期,平均失效次数超过2000周期,但最终所有的样品均没通过测试,第2组填充B胶BGA封装焊点的试样基板,第一次失效与第1组试样基板周期相近,但平均失效周期增加了约50%,超过3000周期,约三分之一试样通过测试,第3组填充D胶BGA封装焊点的试样基板,第一次失效略有上升,平均失效周期相对于第1组试样基板几乎增加了一倍,至4170周期,三分之二的样品经过6120周期未见失效,第4组填充E胶BGA封装焊点的试样基板,第一次失效发生在3850周期,其余在测试结束前均未发生试样基板失效,所以无法确定平均失效周期。选取4组试样基板失效的焊点进行金相分析,如图2所示,从图中观察到,焊点失效产生的裂缝主要发生在焊点上,失效主要因BGA焊点与试样基板的热膨胀系数不匹配引发热机械应力,导致焊点疲劳而引起失效。
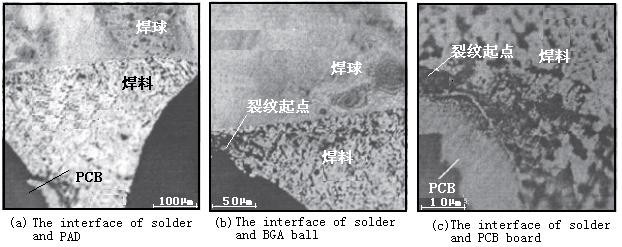
图2 焊点热循环失效SEM图片
BGA焊点开裂,主要原因是由底部填充胶和焊点的CTE差异及温度变化所导致的焊点内部热应力太大所产生。不同填充胶BGA封装焊点热应力可以通过式2-1的一维应力计算模型进行计算,从而能预测该填充胶试样基板是否具有最优异的抗热循环实验能力。

上式中下标d-焊点,j-底胶,ε为杨氏係数;s是BGA焊球与基板焊盘面积,以及α是热膨胀係数,T为环境温度。
利用式2-1,输入焊膏与底部填充胶材料性能参数,可以通过计算,分别得到实验二中方案1、方案2热应力与环境温度关系曲线,如图3所示。得到焊点所受的应力。

圖 4. 利用数学运算,求得在-40?~85?间,底部填充底胶作用在焊点上的热应力
输入表2的底部填充胶B,C及D之材料机械性质于上述方程氏得到图 5。其中斜率高低排名为B > C > D,所以在–40 °C和85 °C,间作用在焊点的热应力的大小排列是 B > C > D,相反的,在表2中显示胶材寿命长短为 B < C < D。由此可见,热应力越小的其寿命越长。

圖 5. 利用数学运算,求得在-40°C~85°C 间, 三个不同的底部填充胶B,C和D 分别作用在焊点上的热应力
接着,将温度范围从 “-40°C~85°C” 改为 “0°C~100°C”,我们可以得到图 6
圖 6. 利用数学运算,求得在0°C~100°C间, 三个不同的底部填充胶B,C和D 分别作用在焊点上的热应力在0°C~100°C间,斜率的排名仍为 B > C > D,所以作用在焊点的热应力还是 B > C > D。相反的,表2显示其寿命周期则为B < C < D即使底部填充胶B的寿命周期最短,它仍能在40°C~85 °C间,达到1141周期。在0°C~100°C 间达到1216周期,这已超过一般产品的要求,1000周期。比较表2与图 5和图 6后,我们可以发现,热循环实验和热应力计算结果有非常好的关联性。热应力越小的,其疲劳寿命越长。
6. 结果与讨论
跌落实验显示,未添加填充剂的底部填充胶比添加填充剂的提供手机更佳的耐跌落实验性能。未添加填充剂的底部填充胶B具有较长的跌落实验寿命,约为添加填充剂之底部填充胶A的2倍左右。
从热循环实验结果显示,使用未添加填充剂的底部填充胶能够提供适当的耐热循环能力。在条件 1, (-40 °C ~ +85 °C) 时,未使用底部填充胶时,第一次失效是在324周期,有底部填充胶则耐1141个周期,故已达到一般的可靠度要求 1,000周期。条件 2,不使用底部填充胶或使用未添加填充剂的底部填充胶时,第一次失效均已超过 1000个周期,MTTF则分别是 2294到3221个周期。有添加填充剂的底部填充胶,因其热膨胀系数低,所以呈现优异的热循环测试结果。然而,在某些应用中,未添加填充剂的底部填充胶也能提供适当的耐热循环性能。从跌落测试和热循环测试所产生的不同失效方式,可看出不同的材料性能参数会影响产品耐可靠性的等级。对于跌落测试而言,具有较高韧性的底部填充胶,绿漆和叠层,可以减少裂纹的产生和延伸扩展,进而提高耐跌落测试能力。致于热循环实验,则应注意组装结构中的所有材料之热膨胀系数是否匹配。比较热应力计算结果与热循环测试实验结果可以看出,较低的热膨胀系数低,所产生的热应力也比较低,其热循环测试的寿命相对的也比较长。未添加填充剂的底部填充胶相对于添加填充剂的底部填充胶,前者提供了制程的好处。诸如: 因黏稠度低,所以流动性佳。在成本考量上,使用未添加填充剂的底部填充胶,由于黏度及密度均低,所以可以减少制程时间,提高量产的生产效率。对少量生产的公司而言,因点胶所需的压力低,所以可以使用较低成本的设备,不必采用具高压气阀的点胶设备。
7. 结论
当产品应用于跌落实验和热循环测试均很重要的情况下,未添加填充剂的底部填充胶通常能满足一般的需求。为了保险起见,可先用数学运算预估并比较不同胶材所产生的热应力。但当热循环测试条件相当严格或组合材料性质差异太大,而导致热应力非常大时,则需改用添加填充剂的底部填充胶以降低其热膨胀系数,进而减少热应力,提高耐热循环测试能力。然而,假若能满足热循环测试要求,则使用未添加填充剂的底部填充胶,能够有较佳制程方便性,诸如: 高流动性极快速固化等。
